在SMT貼片加工中,虛焊、立碑、偏移三大缺陷直接影響一次直通率與交付可靠性。
一、虛焊:焊點看似連、實則斷
1.1 現場特征
- AOI/外觀:焊點尖瘦、發暗、少錫;輕微按壓組件功能時好時壞
- ICT:接觸電阻>1 Ω 或出現間歇開路
1.2 5分鐘快速排查表
① 焊膏印刷——鋼網開口是否被堵?刮刀壓力是否過大導致刮薄
② 零件/PCB——引腳或焊盤有無氧化、露水痕跡
③ 貼片壓力——壓力過小引腳未吃錫;過大把錫擠出焊盤
④ 溫度曲線——峰值溫度是否低于焊膏熔點3℃以上;預熱時間<60s助焊劑揮發不充分
1.3 閉環對策
- 每班首件做X-ray切片,確認金屬間化合物(IMC)連續
- 建立焊膏回溫→攪拌→使用≤8hSOP,現場加裝計時器自動報警
- 對大面積銅箔焊盤,采用網格+熱阻設計,并在爐溫程序里增加頂部補償5℃
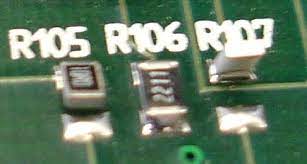
二、立碑:片式元件一端翹
2.1 現場特征
- 0402/0201電阻電容一端翹起,與焊盤分離>0.1mm
- 多出現在回流焊后第一冷卻區,良率波動大
2.2 5分鐘快速排查表
① 焊盤尺寸——兩邊面積差>10%?一邊與地銅相連散熱過快?
② 錫膏厚度——SPI實測兩邊高度差>15%即為高風險
③ 貼片偏移——偏移量≥25%焊盤寬度時,熔化張力失衡
④ 溫度曲線——150℃前升溫斜率>2℃/s,兩端焊料熔化不同步
2.3 閉環對策
- 設計端統一對稱焊盤+熱隔離DFM規則,內審通過率納入項目考核
- 0.12mm激光鋼網+納米涂層,保證印刷一致性
- 回流焊采用勻速升溫—保溫—慢冷四段式,峰值區升溫斜率≤1℃/s

三、偏移:元件不在中心
3.1 現場特征
- AOI報告X/Y方向偏移>0.05mm(細間距>0.03mm)
- 后續波峰或功能測試出現橋連、虛焊連鎖缺陷
3.2 5分鐘快速排查表
① 貼片機——吸嘴真空值<-60kPa?視覺定位誤差>1 pixel?
② 傳輸導軌——皮帶速度波動>±2%或夾持不緊導致板振
③ 錫膏黏度——黏度掉至≤300Pa·s,元件被熔錫自對準力拉偏
④ 板彎——FPC或薄板(≤0.6mm)未使用治具,過爐變形
3.3 閉環對策
- 每班次做CPK≥1.33的貼裝GR&R,數據自動回寫MES,異常自動鎖機
- 0201/0.4mm pitch零件強制使用防偏移吸嘴+兩段降速模式
- 對柔性板采用磁性治具+五點支撐,爐溫預熱區增加平臺預熱30s,減少熱變形

四、預防型體系:把問題擋在第一片板之外
-
三段檢驗:
來料段——焊膏/零件/PCB 100%掃碼批次追溯
制程段——SPI→AOI→X-ray 閉環數據<5min回寫
出貨段——FCT+抽檢100X鏡檢+恒溫恒濕老化2h -
四件裝備:
激光鋼網+納米涂層、在線3D SPI、AOI、12溫區回流焊 -
五個標準化:
設計規范、工藝參數庫、設備點檢表、培訓手冊、異常響應SLA
五、結論
虛焊、立碑、偏移并非單一設備或材料導致,而是設計-材料-設備-工藝-環境系統問題的集中爆發。1943科技通過快速排查表+閉環對策+預防體系,將三大缺陷綜合不良率控制在150ppm以內,幫助客戶平均縮短8%交付周期、降低12%返修成本。若您正面臨類似困擾,歡迎聯系我們,共同把直通率拉到新高度。








 2024-04-26
2024-04-26

